半導体のドライエッチング時の形状を精密に判定・制御する
半導体の製造工程ではゲート形成工程等にプラズマエッチング技術が用いられています。
放電により発生する活性なイオンを利用したイオン支援エッチングはRIE(Reactive Ion Etching)技術として半導体装置の微細化に欠かせない技術となっています。しかし、エッチング処理条件の設定、監視、制御、最適化は困難な作業であり、プロセスエンジニアは目標形状を得るためのパラメータ設定値をtrial & errorにより決定しているのが現状です。
この発明はエッチングの終点としてエッチング深さだけではなく、基板上に形成するゲート等について複数の特徴量を設定し、それぞれの形状パラメータ値を監視し制御するためのシステムに関する発明です(特開2017-195365)。
ここでは先ずエッチングプロファイルモデルを作成します。エッチング処理中にガス中のラジカルやイオンによりプラズマ発光が生じます。この光信号は反射、屈折、回折として測定されます。これを予測モデルの独立変数とします。従属変数はエッチング形状で、例えばエッチング深さ、クリティカルディメンション、ピッチ等です(図1)。次に光信号と従属変数である形状パラメータおよび非形状パラメータ(プロセス条件)の関係を示すトレーニングセットを実験的に、または計算によって生成します。光信号と形状の関係を回帰モデルやニューラルネットワークなどの手法によりモデル化します(図4)。形状パラメータはエッチング時間の関数であり、また光信号もエッチング時間の関数です(図2)。従って時間ステップ毎に最適なモデルを作成することになります。
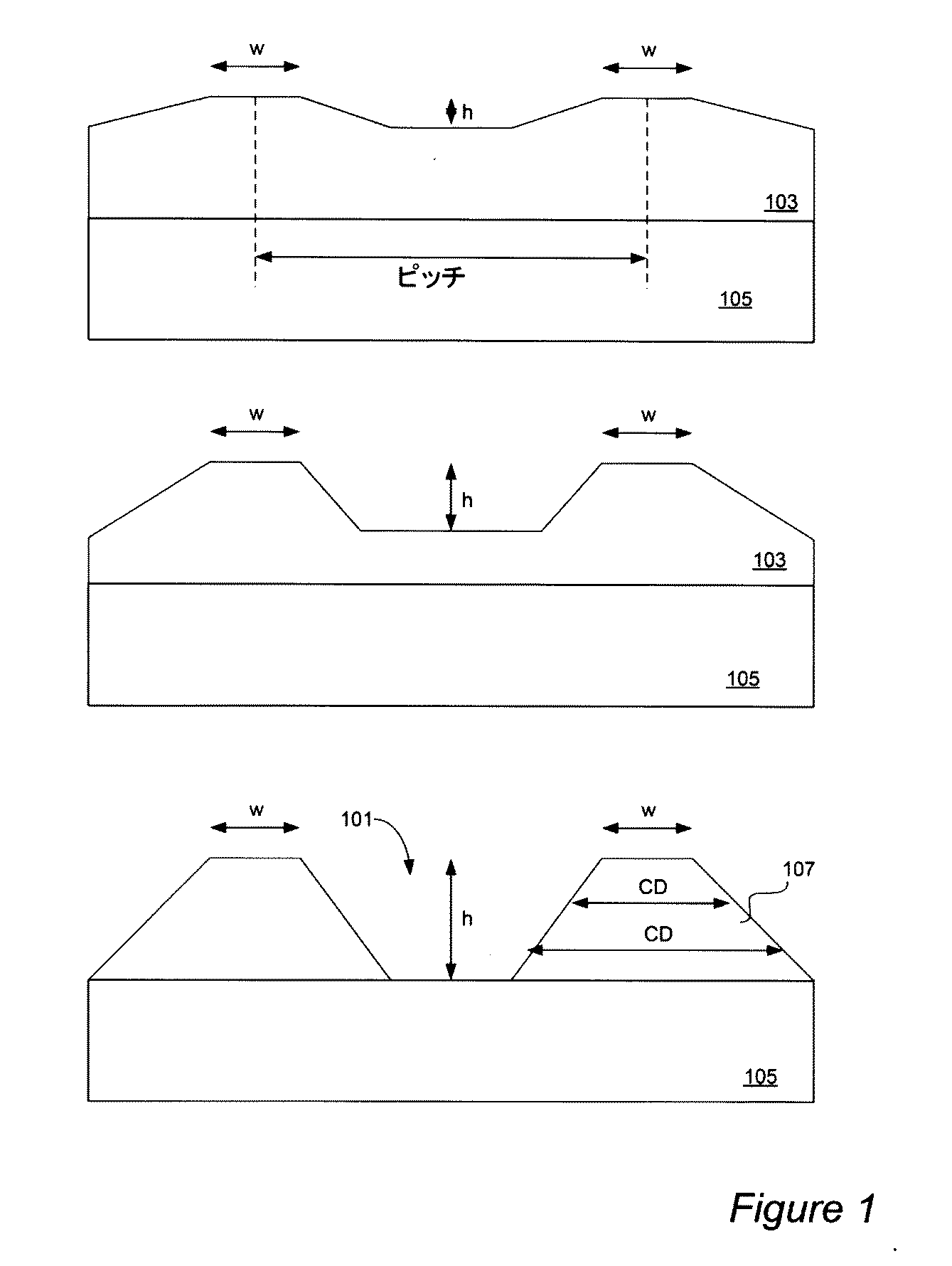


これが得られると光信号をモニタすることでエッチング進行に伴う形状変化がリアルタイムで推定でき、エッチングパラメータを調整して目標とする形状に近づけたり、エッチング終点を判定したりすることが可能となります。
本発明の請求項2に非目標形状パラメータとの表現がありますが、これはエッチンング処理を行うためのプロセス条件、例えば電磁場条件、処理ガス、ガス流量、圧力等を示しているものと思われます。